商机详情 -
非标外壳组装兼容设备价格
伴随着电网规模越来越大,电压等级越来越高,电力系统朝着更加智能化方向发展,高压、大功率和高开关速度要求功率器件承担的功能也更加多样化,工作环境更加恶劣,在此背景下,除芯片自身需具有较高的处理能力外,器件封装结构已成为限制器件整体性能的关键。而传统的封装或受到材料性能的限制或因其自身结构设计不能适应高压大电流高开关速度应用所带来的高温和高散热要求。为保证器件在高压高功率工况下的安全稳定运行,开发结构紧凑、设计简单和高效散热的新型功率器件,成为未来电力系统用功率器件发展的必然要求。IGBT自动化设备的动态测试具备实时监测和报警功能。非标外壳组装兼容设备价格

功率器件封装结构散热设计原则:从器件散热的角度,封装结构设计应当遵循散热路径低热阻、尽可能多散热路径和传热路径上的接触面积尽可能大的原则。这就要求在设计之初,就应考虑到封装材料的选择、散热路径的设计、散热路径上各部件接触界面的面积等。但这些不可避免的增加了封装设计和工艺实现的难度,一种功率器件的封装实践往往是考虑多种因素的折中。从目前国内外对于功率器件的研究和开发现状来看,具备耐高温、多散热路径和大面积连接的封装特征是未来功率器件封装的发展趋势,也是满足未来高压、大功率器件工作性能要求的必然选择。非标外壳组装兼容设备价格通过激光打标,IGBT自动化设备能够在模块表面添加必要的标识和信息。
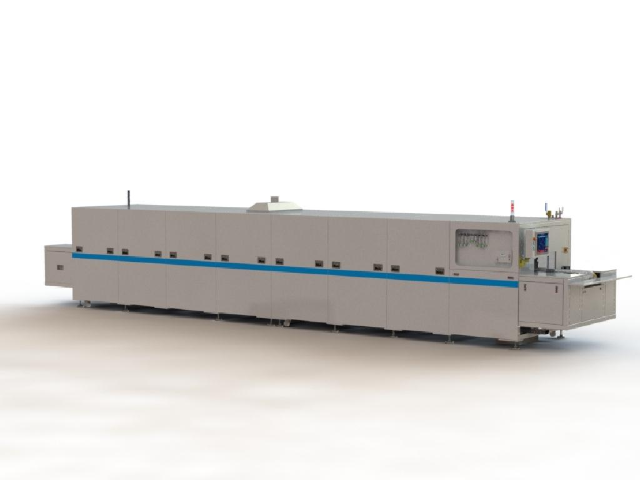
为追求更加优异的散热性能,研究人员提出了嵌入式功率芯片封装的双面液体冷却方案。该嵌入式封装由扁平陶瓷框架、嵌入式芯片、介电夹层和沉积金属化层互连组成[84]。将芯片嵌入到具有开槽的陶瓷框架中,并在固化炉中用粘性聚合物将芯片四周进行粘接并固化,形成的平坦表面为平面加工提供了平台。使用聚合物丝网印刷方法在其上涂上介电夹层。通过通孔与芯片的铝金属焊盘相对应,然后在其上沉积金属层,进行图案化,引出芯片正面的功率电极。
无键合线单面散热:取消键合线有助于改善器件封装寄生电感和封装可靠性。超紧凑高可靠性SiCMOSFET模块,取消键合线和底板,将芯片直接焊接到基板上,采用铜针取代铝键合线,同时在高导热SiN陶瓷上设计了类似于热扩散器的更厚铜块,具有更好的传热效果。相比Al2O3陶瓷基板的键合线结构,采用Al2O3陶瓷的厚铜块封装模块结壳热阻降低37%,采用SiN陶瓷的厚铜块封装模块结壳热阻降低55%。同时该封装采用新型环氧树脂和银烧结技术,具有高达200℃的高温运行能力。动态测试IGBT自动化设备可分析和优化器件在过温和过压情况下的性能。

创新性的横向弹簧针端子和Mo柱互连解决了现有标准化封装在功率密度和热性能方面的不足,提供芯片顶部和底部的热通路,从而提高散热能力。采用烧结银将芯片连接在两个高导热AlN陶瓷DBA基板之间,通过Mo柱将芯片的源极和栅极连接到上基板,减轻了热机械应力,改善了可靠性。Cu柱支撑封装两侧的基板,并为横向弹簧针端子提供安装表面,横向弹簧针穿过3D打印的外壳将模块连接到高压PCB母线。外壳和弹簧针端子之间采用硅胶垫圈密封,防止密封剂泄漏。将器件安装在两个PCB母线之间,可以实现高密度集成和高度模块化。IGBT自动化设备在电动汽车主逆变器功率半导体技术方面处于先进水平。非标外壳组装兼容设备价格
自动化设备的使用提高了IGBT模块封装工艺的一致性和可靠性。非标外壳组装兼容设备价格
键合线与半导体器件间存在材料热膨胀系数的不匹配,使得线键合处往往成为易失效位点,甚至出现裂纹或者松动,导致接触不良,使键合点处的接触热阻增大,温度升高,加速该点的失效。无键合线单面散热器件芯片与基板的连接与键合线连接器件相同。无键合线面互连封装降低了封装寄生电感和电阻,大的接触面积增强了传热。上述封装结构只能通过由芯片底部的陶瓷基板和底板构成的路径进行散热。目前键合线连接的硅基器件单面散热封装结构已接近其散热极限,硅芯片的工作结温也接近其承受上限,严重影响了器件的性能,更限制了具有更高温度运行能力的SiC器件的性能。从散热的角度看,功率器件产生的热量只能通过底面传递,限制了其散热性能。在目前封装材料性能和封装工艺暂时无法取得较大改善的情况下,通过创新结构布局和设计,优化散热路径,是解决功率器件封装散热的有效方案。非标外壳组装兼容设备价格